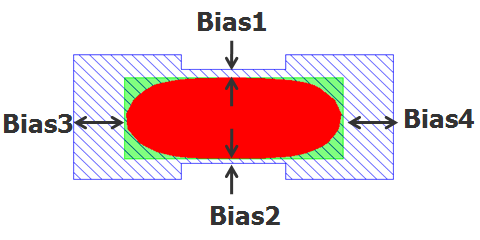 |
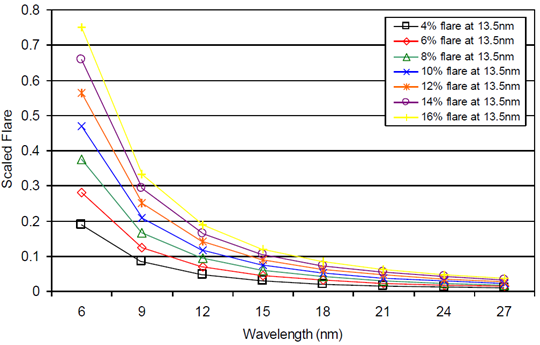 |
|
| EUV Flare and Proximity Modeling and Model-based Correction | Longer Wavelength EUV Lithography (LW-EUVL) | |
EUV
C. W. Maloney, B. W. Smith, "Longer Wavelength EUV Lithography (LW-EUVL)" Proc. SPIE 8322, (2012) paper
C. Zugina, J. Word, R. Chalasani, M. Lam, M. Habib, G. F. Lorusso, E. Hendrickx, B. Baylav, "EUV flare and proximity modeling and model-based correction" Proc. SPIE 7969, (2011) paper
Copyright 2007 Society of Photo-Optical
Instrumentation Engineers.
These papers were (will be) published in Proceedings of SPIE, Microlithography and are made available as electronic reprints (preprints) with permission of SPIE. One print or electronic copy may be made for personal use only. Systematic or multiple reproduction, distribution to multiple locations via electronic or other means, duplication of any material in this paper for a fee or for commercial purposes, or modification of the content of the paper are prohibited.
